
意芯半导体,专注于存储、电源、芯片级物联网模组及SIP系统化封装设计。拥有世界先进的半导体封装制造设备和经验丰富的研发制造团队。芯片提供、封装方案设计、封装和测试服务提供。



松下高速机(MPM-D3)行业内最高置件精度(+/-30um),精确的置件压力控制,可满足最小01005,微間距銅凸塊以及CSP倒裝晶片封裝;双轨双平台高效生产模式,可以实现双轨同步,正背面实现同步生产

高效率全自動光學自動檢驗能力;
100% SPI ,AOI外觀檢驗,可以涵蓋全部外觀不良檢驗, 如锡少,短路,缺件,墓碑,極性反,偏移,沾污等

引用先进的ERP&MES管理系统,
让企业在同行领域中更具有竞争力。

尺寸:12“、8”,以及各种MPW,CSP规格晶圆
材料:可指定胶膜型号
CTQ(关键质量特征) Cutting-edge≤0.3mm

尺寸:12“、8”,以及各种MPW,CSP规格晶圆
最小减薄厚度可至:12"=>25μm;8"=>50μm
CTQ(关键质量特征):正片晶圆厚度精度+/-3um;单科芯片厚度<1um

划片规格:12",8"硅圆片
划片优势:划片槽宽度≤35μm,芯片/基板厚度:≤1.0mm,划槽预留宽度:≥50μm
最薄划片硅圆片厚度≥40μm
切割偏移精度:2um/ 300mm@3sigma
X/Y 位置:±15um
旋转:50-150mdeg
贴片压力:0.5-25 N
贴片头旋转角:360°
贴片头加热:200°C Max
预/贴/后加热:200°C / 250°C / 200°C
贴片模式:压力&位置(高度)
长:120-300mm(90mm可选)
宽:29-120mm
厚度:0.08-0.8mm
工业界的先驱以及领导者,同时进行取芯片、传送芯片、以及置放芯片:
领先优势的产能与精度
冷取 / 热放 的能力
优化的取放工具件让制程更具灵活性的发展空间
在生产中检查可以消除贴装時使用到不良芯片的可能性
画胶以及贴片头使用独特的内建校正器来不断重新校准:
消除漂移与随生产时间产生的中心偏移

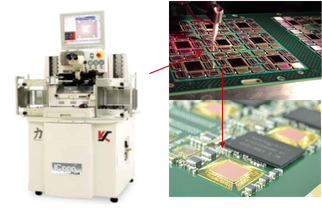
焊接精度2um@3sigma;
焊接间距35um@3sigma 线弧能力:最长线弧7.6 mm 对于 1.0 mil 焊线 3.0 mm 对于 0.6 mil 焊线最低线弧高度40 μm 对于 0.6 mil焊线80 μm 对于 1.0 mil焊线线弧摆幅焊线长度 < 2.54 mm: 25 μm @ 3 sigma 焊线长度 > 2.54 mm: ± 1 % wire length @ 3 sigma
封装 / 引线框尺寸:长度: 90 至 300 mm ( 短于100 mm的引线框需要额外短料盒操作工具) 宽度: 15 至 95 mm 厚度: 0.10 至 1.1 mm 焊接垫下沉深度: 可达 2.3 mm
将wire bond好的芯片及基板或框架用EPOXY MOLDING COMPOUND 进行封装起来,防止外界的物理冲击及化学不变化对芯片及电路造成损伤和破坏。

月产能:6kk 适用基板规格(宽):20-78mm
适用基板规格(长):124-265mm
适用基板规格(厚):0.1-1.0mm
Mold cap:0.5-3.5mm Mold cap
厚度公差:±30um
合模压力:max.120ton
注胶压力:max.3.0ton


请联系意芯,告诉我们您的需求
联系我们浙江:丽水市莲都区南明山街道龙庆路356号
广东:深圳市福田区金田路3038号现代国际大厦
电子邮件:icyc@icycsemi.com
网址:http://www.icycsemi.com
联系电话:0578-2630600(丽水)
0755-88338583(深圳)